

苏州芯矽电子科技有限公司
联系人:陈经理
号码:18914027842
邮箱:Jakechen@szsi-tech.com
地址:江苏省苏州市工业园区江浦路41号
半导体 RCA 清洗工艺是一种用于晶圆清洗的湿式化学清洗法,由 RCA 公司的 Kern 和 Puotinen 在 1965 年发明,并在 1970 年发布。
清洗液组成
SC-1 溶液:由水、过氧化氢和氢氧化铵混合而成,也被称为 “氨 / 过氧化物混合物”。其常用的体积比例为 H₂O:H₂O₂:NH₄OH=5:1:1 至 7:2:1,通常使用的是 5:1:1 的比例。过氧化氢是电子级 30% 的 H₂O₂,氢氧化铵为 29% 的 NH₄OH。
SC-2 溶液:由水、过氧化氢和盐酸混合而成,也称为 “盐酸 / 过氧化物混合物”,常用体积比例为 H₂O:H₂O₂:HCl=5:1:1 至 8:2:1,一般采用 5:1:1 的比例。其中 HCl 浓度为 37wt%。
清洗原理
SC-1 清洗原理:硅片表面有一层自然氧化膜,呈亲水性,清洗液可浸透硅片表面和粒子之间。由于硅片表面的自然氧化层与硅片表面的 Si 被 NH₄OH 腐蚀,因此附着在硅片表面的颗粒便落入清洗液中,从而达到去除粒子的目的。同时,H₂O₂ 又在氧化硅片表面形成新的氧化膜。
SC-2 清洗原理:主要用于对硅片表面金属沾污的清洗。在酸性溶液中,pH 值越低,金属越不易附着在硅片上。SC-2 溶液中的 HCl 等成分可使金属离子化,并与溶解的离子形成可溶性金属络合物,防止金属重新沉积在硅片表面,从而达到去除金属沾污的目的。
清洗流程
SC-1 清洗:将晶圆放入 SC-1 溶液中,在 70-75°C 下处理 5 至 10 分钟,然后用流动去离子水进行淬火和溢流冲洗,以去除有机污染物和部分金属杂质。
SC-2 清洗:将晶圆放入 SC-2 溶液中,同样在 70-75°C 下处理 5 至 10 分钟,然后进行淬火和溢流冲洗,以去除硅表面的碱残留物和金属沾污。
初步清洁:去除粗大的杂质,包括图案化后的光刻胶掩模等,可通过干法或液体方法完成,如氧基等离子体的反应性等离子体辅助清洗等。
RCA 标准清洁
后续处理:如果需要,可以进行一些修改步骤,如用高浓度剥离 SC-1 之后形成的水合氧化膜,以便重新暴露硅表面以进行后续 SC-2 处理;也可以根据具体情况对 SC-1 和 SC-2 进行稀释等操作。
干燥:清洗完成后,将晶圆在冷的流动去离子水中冲洗,然后干燥。如果无法立即处理,可将晶圆转移到用预过滤氮气冲洗的玻璃或金属外壳中进行储存。
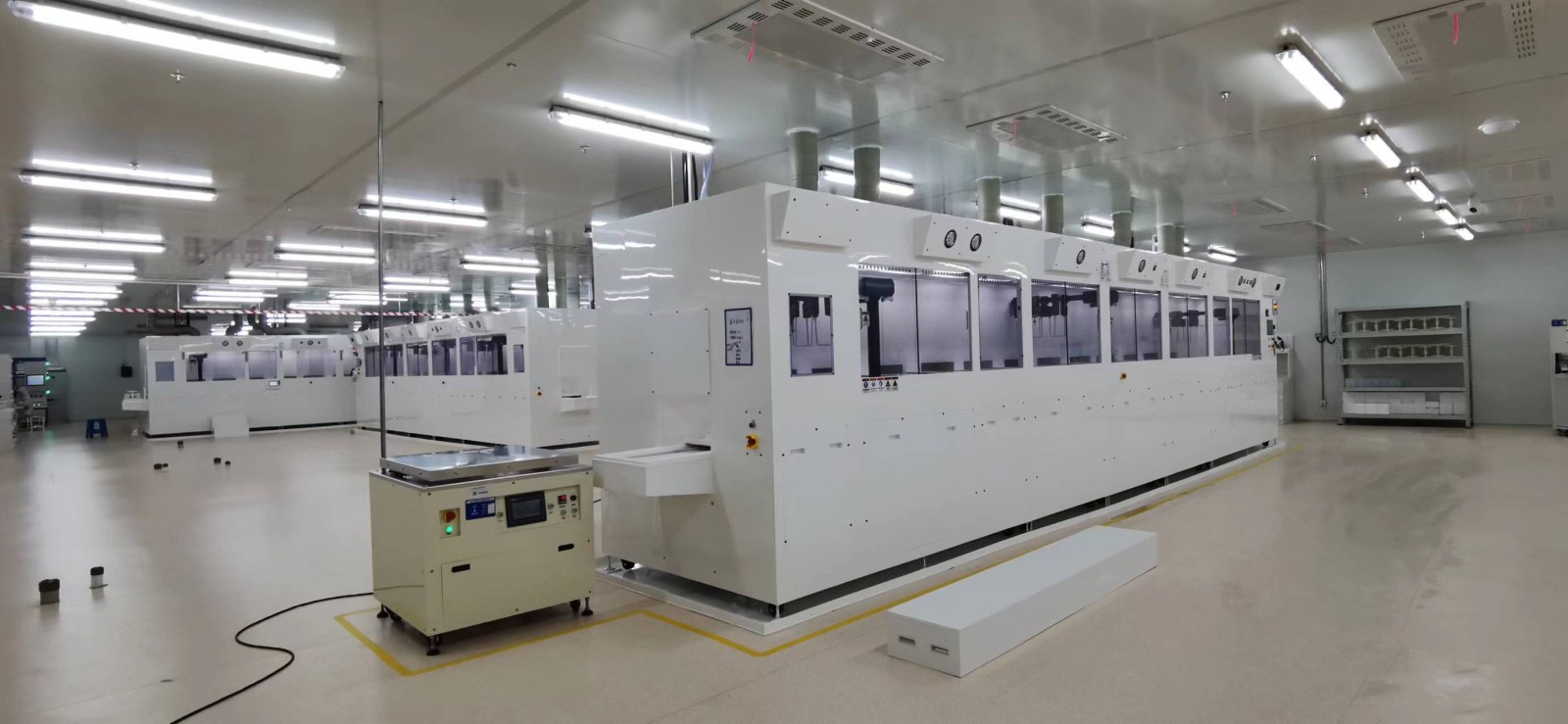
半导体 RCA 清洗工艺在半导体制造中至关重要。它通过特定清洗液和流程去除晶圆表面杂质,保障产品质量和性能。随着技术发展,该工艺不断优化改进,为半导体产业的持续进步提供有力支撑。